前のページにもどる
厚膜ポジティブ/ネガティブ・トーン・フォトレジスト
400nm近傍の波長に感度を有する厚膜フォトレジスト。マスクレス・リソグラフィのアプリケーションを拡げます
- グレイスケール露光に対応したポジティブ・トーン (~60μm厚)
- 高アスペクト比パターンの形成が可能なネガティブ・トーン (~150μm厚)
- ニッケル電鋳に対応
市販のマスクレス・リソグラフィ装置では、主に400nm波長の光源が標準採用されています。一方従来の厚膜フォトレジストは、主にUV帯域に感度を有するものが殆どで、厚膜アプリケーションに対応するには、オプションの高価なUV帯域光源を搭載しなければならず、また従来の厚膜レジストはグレイスケール露光に対応したものが市場ありませんでした。この背景から、Micro Resist Technology社により、400nm近傍波長に感度を有する厚膜のレジストが開発されました。
主な特徴と描画例
ポジティブ・トーンma-P 1275G(グレイスケール露光対応)
- ~60μm厚まで成膜可能
- 酸、アルカリ・メッキ槽内での高い安定性
- 水溶性アルカリ現像液 (TMAH系)
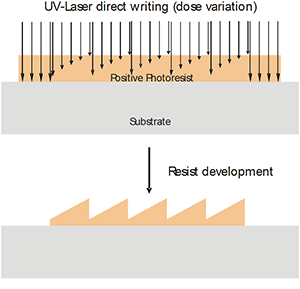 | 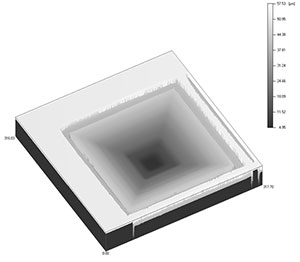 |
| グレイスケール露光に対応 | 53μmに至るパターン深さを実現 |
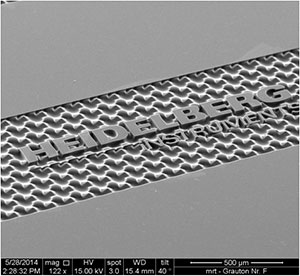 | 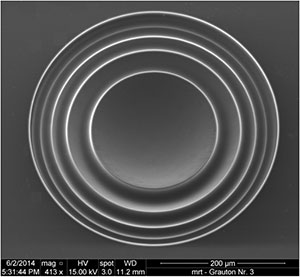 |
| グレイスケールとバイナリ・パターンの混在 | フレネルレンズ |
ネガティブ・トーンmr-DWL
- ~150μm厚まで成膜可能
- 高い温度、化学的安定性
- 専用現像液mr-Dev
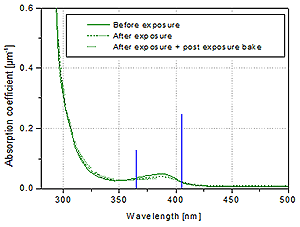 | |
| 感度曲線 | 150μm厚、アスペクト比≧10 |
 | 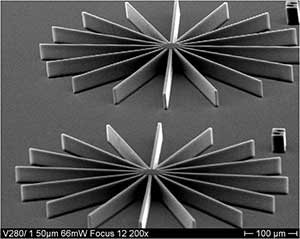 |
| 50μm厚、4μmピラー、アスペクト比12.5 Cadarso et al, J. Micromech. Microeng. 2011 | 50μm厚、5μmスター、アスペクト比10 Cadarso et al, J. Micromech. Microeng. 2011 |